 2023-09-07
2023-09-07 1480
1480
編者按
Editor's note
半導體(tǐ)行業芯片測試,與芯片設計、芯片制造、芯片封裝(zhuāng)并舉稱為(wèi)半導體(tǐ)的四大産(chǎn)業,測試在半導體(tǐ)産(chǎn)業鏈中(zhōng)是不可(kě)或缺的環節。
半導體(tǐ)芯片測試主要包括晶圓級測試(CP測試)、芯片級測試(FT測試)、系統級測試(SLT測試)等,測試是對集成電(diàn)路産(chǎn)品的設計、流片、封裝(zhuāng)各個環節産(chǎn)出品是否合格的檢測,是集成電(diàn)路在電(diàn)子設備整機應用(yòng)時可(kě)以正常安(ān)全工(gōng)作(zuò)的保障。
半導體(tǐ)芯片測試,通常由ATE(Automatic Test Equipment)完成,由于半導體(tǐ)屬于批量制造,ATE産(chǎn)生的數據量非常大,且數據維度豐富,通常一個Lot批次的數據就有(yǒu)幾十個G的大小(xiǎo),而每天生産(chǎn)線(xiàn)都是數千個批次的持續生産(chǎn),這樣積累了大量的半導體(tǐ)測試數據。
我們意識到,利用(yòng)諸如AI、機器學(xué)習等技(jì )術來挖掘數據價值,不僅可(kě)以帶來測試效率的提升,保證産(chǎn)品良率,還能(néng)通過數據分(fēn)析優化測試方案,控制成本,同時測試不良品電(diàn)性特征的分(fēn)析也為(wèi)芯片設計改善、制造工(gōng)藝改善提供改善方向。
ATE測試産(chǎn)生的DATALOG數據,多(duō)以STDF(Standard Test Data File)為(wèi)标準格式。STDF文(wén)件裏記錄了360全方位的芯片測試結果,DMS(Data Monitoring System)産(chǎn)品,通過數據挖掘與分(fēn)析技(jì )術,可(kě)以實現基于Lot的分(fēn)析、基于Wafer的分(fēn)析(CP),基于Die(晶圓顆粒)的分(fēn)析,包括每顆産(chǎn)品的每個測試項的數據分(fēn)析,可(kě)以更加清晰、全面地識别芯片産(chǎn)品隐藏的品質(zhì)特征。
下面我們通過DMS軟件對ATE測試文(wén)件的初步分(fēn)析,羅列幾種比較常見的應用(yòng),也歡迎各位行業從業者一起參與,共同交流。
良率Yield情況(産(chǎn)品健康狀況/成本狀況):快速生成基于批次号/晶圓批号的良率、不良品、TOP5失效參數及失效率的可(kě)視化應用(yòng)。

快速分(fēn)析不良品Defect的主要失效Drilldown,從而快速找到設計/制造關鍵薄弱點,重點提升。

對合格品的測試數據離散度情況(SPAT整機性能(néng)一緻性)進行分(fēn)析,從而實現:
1)測試标準規範制定狀況(CPK特征/工(gōng)藝穩定性)
2)測試Sites間參數特征(測試接觸/探針狀況/測試模塊元件參數一緻性)

通過片間參數波動狀态,對流片工(gōng)藝穩定性進行直觀分(fēn)析。
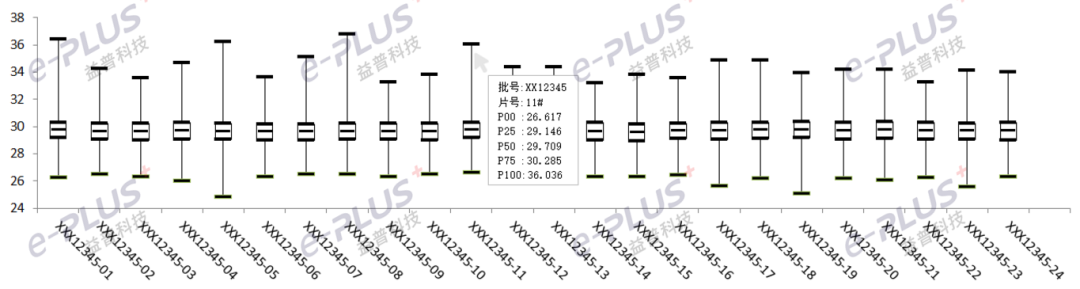
快速識别圓片區(qū)域失效狀況,對流片工(gōng)藝/設備穩定性及異常進行直觀的分(fēn)析。

參數離群點剔除情況(DPAT)

鄰近區(qū)域離群點剔除情況(NNR)
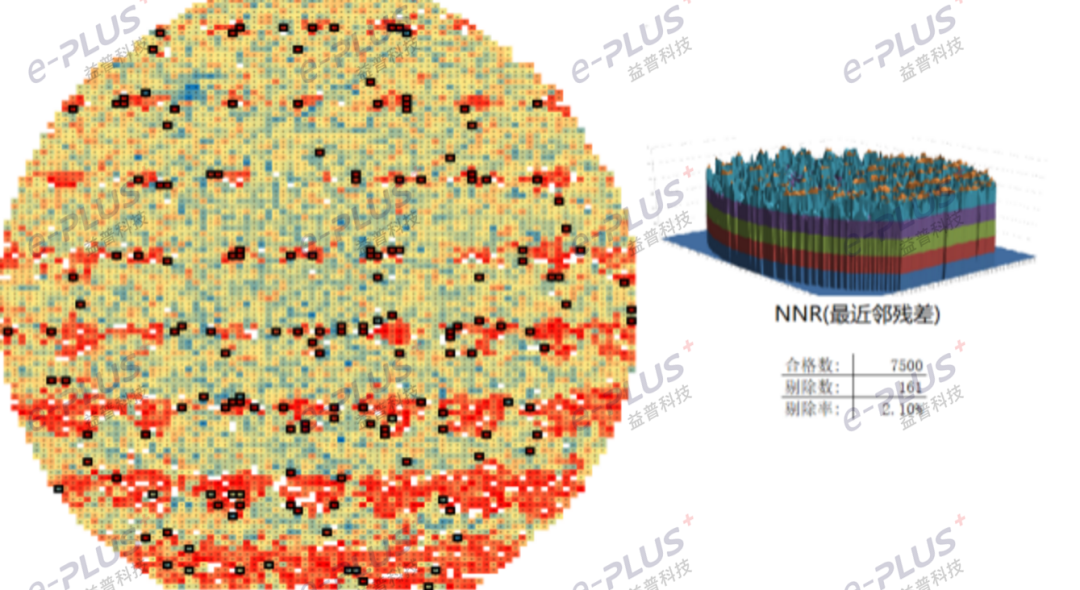
集中(zhōng)失效區(qū)域邊緣過渡點剔除情況(CD)
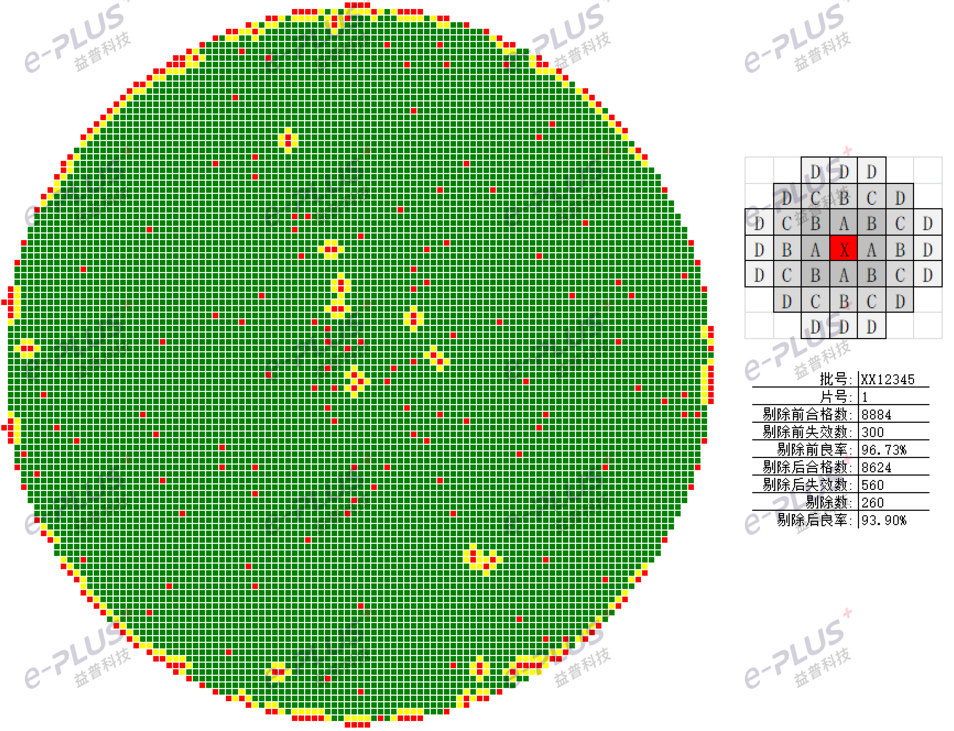
圓片邊緣失效頻度情況(GoldenMap測試去邊管理(lǐ)/産(chǎn)品可(kě)靠性)

上一篇: 一期一會 | 益普第109 & 110期老友會:誰是數字化轉型的寵兒? 下一篇:喜訊 | 益普科(kē)技(jì )作(zuò)為(wèi)首批供應商(shāng)入駐深圳市工(gōng)智聯産(chǎn)業數字融合發展促進中(zhōng)心